Képalkotó és felületvizsgáló módszerek két nagyobb csoportra oszthatók a) elektronmikroszkópiás módszerek, b) mérőcsúccsal való letapogatást alkalmazó pásztázó módszerek. Mivel ezek a módszerek a hagyományos képalkotó eljárásoknál (pl. kamerák, fénymikroszkópok) sokkal nagyobb, közel atomi felbontással rendelkeznek, azért ezeket a módszereket ultramikroszkópiás módszereknek is szokták nevezni.
A transzmissziós elektronmikroszkóp (transmission electron microscopy, TEM) működése az optikai mikroszkópokhoz hasonló. Az elektronágyúból kilépő elektronnyalábot (lásd 3.1.1 fejezet) elektrosztatikus lencserendszer vezeti a mintára. A minta nagyon vékony (max. néhány száz nm), elektronokkal „átvilágítható”, így a minta alkotóival nem ütköző elektronok átjutva egy fluoreszcens ernyőn képet adnak. A kép felbontása az Abbe-képlet alapján 0,1 nm körül van, ami mintegy három nagyságrenddel nagyobb az optikai mikroszkópoknál elérhető értéknél. A TEM elsősorban azonban leképezésre és kevésbé – a kémiai értelemben vett – analízisre szolgál.
A pásztázó elektronmikroszkóp (scanning electron microscope, SEM) működési elve alapvetően eltér a TEM-től. A képalkotási elve a pásztázáson alapul, vagyis nem egyidőben, hanem pontról-pontra haladva folyamatosan képezi le minta felületétet egy nagyon kis pontba fókuszált elektronnyalábbal, a visszaverődött elektronokat detektálva.
A besugárzó elektronok energiája azonban gerjeszti a mintát alkotó atomok elektronjait is. A felvett energia jelentős része röntgensugárzás formájában emittálódik, így a kilépő röntgensugárzás energiájának vagy hullámhosszának mérésén keresztül (EDS/EDX illetve WDS - lásd 6.5 fejezet) azonosítható a jelenlévő elemek minősége is. A képalkotás képességével kombinálva ez lehetővé teszi elemeloszlási térképek felvételét is Ez utóbbi eljárásokat összefoglalóan electron-probe X-ray microanalysis (EPXMA/EPMA) módszernek nevezzük. Az elektronnyalábbal történő gerjesztés hatására létrejöhet a mintában az Auger-effektus is.
Ernst Ruska 1931-es prototípusát továbbfejlesztve az első, gyakorlatban is használt nagyteljesítményű elektronmikroszkópot 1938-ban Albert Prebus és James Hillier építették meg.
A SEM készülék felépítését az alábbi ábra szemlélteti. Az elektronforrás többféle típus is lehet, legelterjedtebbek a termoemissziós és téremissziós elektronforrások (lásd 3.1.1. fejezet). A modern technológiát a téremissziós katóddal működő készülékek (FESEM) jelentik.
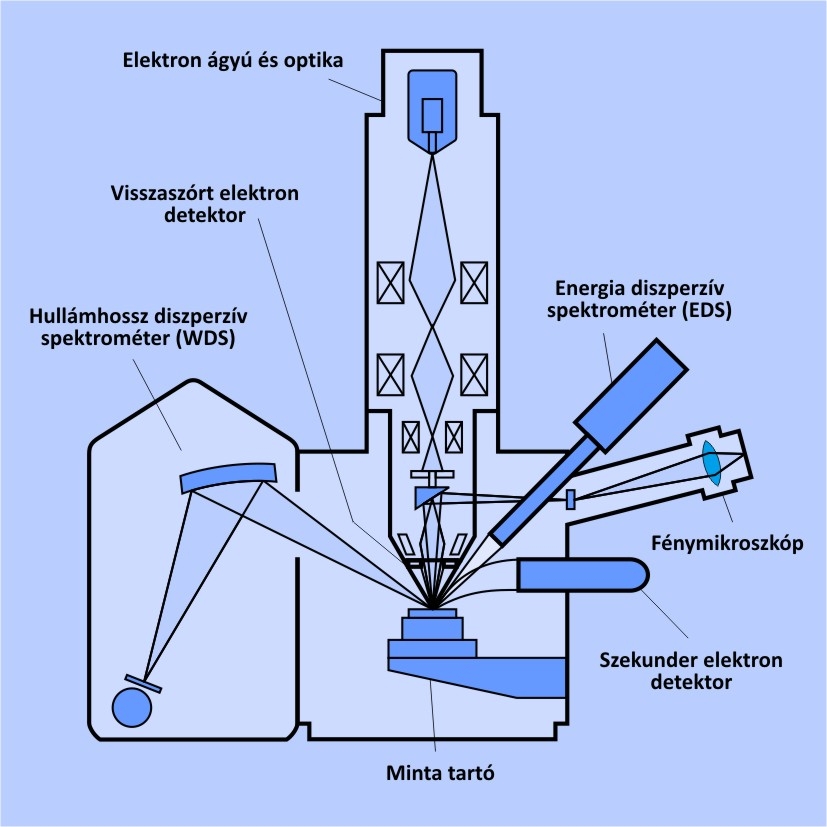
Egy pásztázó elektronmikroszkóp (SEM) készülék vázlatos felépítése
Hagyományos SEM készülékben csak vezető felületű mintákat lehet vizsgálni, mivel a szigetelő minták az elektronokkal való bombázás során elektromosan feltöltődnek. Szigetelő minták vizsgálatához ezért előzetesen nagyon vékony arany vagy szén réteget párologtatnak a felszínre. Az EDX vizsgálathoz célszerű szén bevonatot választani, mivel ez kevésbé abszorbeálja a mintából keletkező röntgensugárzást (az abszorpció a rendszámmal nő).

Gerjesztési és információs mélység a SEM módszerhez kapcsolódó vizsgálati módszereknél
A mintát érő elektronnyaláb a felszínhez legközelebb eső 1-2 nm mély régióból az Auger-elektronok kilépését indítja el. Az ionizált atomok itt csak elektronsugárzás kibocsátásával (röntgensugárzás nélkül!) relaxálnak. Az elektronok kinetikus energiájának detektálásán keresztül 8.1 fejezetben látott módon az elemanalízis végrehajtható, sőt a felület felett pásztázva és pontról-pontra leképezve a felület elemösszetételének képi megjelenítésére is lehetőség van. Ez a pásztázó Auger-mikroanalízis (Scanning Auger Microprobe, SAM) módszere. A pontos vizsgálatokhoz a háttérként jelentkező másodlagos elektronok kiszűrése is szükséges.
A felület 5-50 nm mélységű rétegéből a K-héjról származó másodlagos (v. szekunder) elektronok lépnek ki. Ezek 50 eV-nál kisebb energiával rendelkeznek, detektálásuk egy oldalt elhelyezett, ún. Everhart-Thornley (E-T) detektorral történik, ami lényegében egy szcintillációs detektor (lásd a 3.3.2.5 fejezetben). Mivel a felszínhez közel helyezkedik el az elektronok forrása, az innen nyert információból készíthető a legjobb felbontású elektronmikroszkópos kép. A másodlagos elektronok száma nem függ a minta összetételétől, ezért kémiai analízisre nem használható, a felhasználás ezen módja tehát a képalkotás.
A minta ennél mélyebben elhelyezkedő rétegiből jutnak ki az ún. visszaszórt (back-scattered) elektronok, amelyek a besugárzó elektronnyalábból a minta atomjainak rugalmatlanul ütközve, majd visszaszóródva képződnek. Ezek nagyobb energiája miatt már az elektronnyaláb tengelye körül koncentrikusan helyezik el a megfelelő detektort. A visszaszórt elektronok szerencsés tulajdonsága, hogy intenzitásuk rendszámfüggést mutat, (a nagyobb tömegszámú elemek erősebben szórják vissza az elektronokat) ezért ezen keresztül lehetőség van a minta kémia összetételének vizsgálatára is.
A kémiai analízis azonban legnagyobbrészt a még mélyebb rétegekből (0,5-10 μm) származó, a minta gerjesztése után röntgensugárzáson keresztüli relaxációval kibocsátott fotonokon keresztül végezhető el. A sugárzás létrejöttéhez az atomból egy belső héjon lévő elektron kilökődik, helyére egy külső héjról lép be egy másik, miközben a felszabaduló karakterisztikus energiát röntgen-foton formájában kisugározza. A jelenlévő atomok azonosítása a sugárzás energiájának (EDX, EDS) vagy hullámhosszának (WDS) mérésén keresztül valósítható meg (lásd 6.5. fejezet)..
Az elektronsugaras mikroanalízis általánosan alkalmazható minden szilárd mintán; és fagyasztással eredetileg más halmazállapotú anyagok is vizsgálhatókká tehetők. A módszer nem-invazív jellege alkalmassá teszi érzékeny minták elemzésére, ennek azonban ellene dolgozik a szükségszerűen alacsony nyomású mintatér. Mára azonban megjelentek az ún. környezeti elektron mikroszkóp (ESEM) és a kisvákuumú mikroszkóp (VPSEM) változatok is, amelyekben akár 6000 ill. 300 Pa nyomáson is lehetséges vizsgálatokat elvégezni. Ezekkel a műszerekkel már szigetelő minták is vizsgálhatók mintaelőkészítés nélkül, amit az tesz lehetővé, hogy az elektronnyaláb által a gáztérben létrehozott pozitív ionok semlegesítik a mintafelület ionizációja során létrejövő negatív töltést. Úgyszintén az érzékeny minták vizsgálatára fejlesztették ki a kisfeszültségű mikroszkópot, ahol 0,2-5 kV gyorsító feszültséggel történik a vizsgálat.
Az elektronmikroszkópia módszerét a leggyakrabban képalkotó eljárásként alkalmazzák, de igen gyakori a keletkező röntgensugárzás kihasználása elemeloszlási térképek felvételére is (EDS vagy WDS elemzés). A kinyerhető analitikai információ az elemösszetétel vizsgálatára korlátozódik, mivel a kötési állapot felderítése ezen a módon nem lehetséges (erre például a korábban említett AES módszerrel van lehetőség). A nagyobb felbontóképesség miatt a TEM használatával elérhető EDS eredmények felülmúlják a SEM-nél leírtakat, így a kimutatási határok néhány nagyságrenddel kisebbek lehetnek, akár 10-20 g-ot elérve.
Az 1980-as években képalkotó méréstechnikák egy egész új osztályát fejlesztették ki, amelyet pásztázó mérőcsúcs mikroszkópiának (Scanning Probe Microscopy, SPM) neveztek el. Ezen ultramikroszkópiás módszerek forradalmi újítása az volt, hogy egy nagyon hegyes tűt (mérőcsúcs vagy mérőszonda) vezetnek végig pásztázó módon a mintafelület felett és a merőcsúcs által szolgáltatott ("letapogatott") jel alapján szerkesztik meg a felület nagyfelbontású képét. Elsőként a Binnig és Rohrer által 1981-ben megépített pásztázó alagútmikroszkóp (Scanning Tunneling Microscopy, STM) született meg, amely készülék kifejlesztéséért a kutatók 1986-ban Nobel-díjat kaptak. Valamivel később, szintén Binnig és munkatársai készítették el a felületvizsgálatok másik jelentős készülékét, az atomerő mikroszkópot (Atomic Force Microscopy, AFM).
Az STM technika alapja, hogy a vizsgálandó minta és a mérőcsúcs között nagyon kis távolság esetén ún. alagútáram jön létre, amely a felületi struktúrát leképező jelként használható. Az alagútáram megértéséhez feltételezzük, hogy a szonda csúcsa és a minta közti távolság kicsi, de az elektronállapotaik függetlenek. Az elektronok átlépését azonban akadályozza a fémekben a kilépési munka (φ) és a távolság (d) által képzett potenciálgát. Ekkor a két fém közé kis feszültséget (0,5-2 V) kapcsolva, a Fermi-szintek (EF) e*V értékkel eltolódnak. (V az alkalmazott feszültség, e az elektron töltése) Ez lehetőséget ad az elektronoknak a magasabb energiájú betöltött állapotból az alacsonyabb energiájú betöltetlen állapotba való átjutásra, a potenciálgát alatti „alagutazásra”.
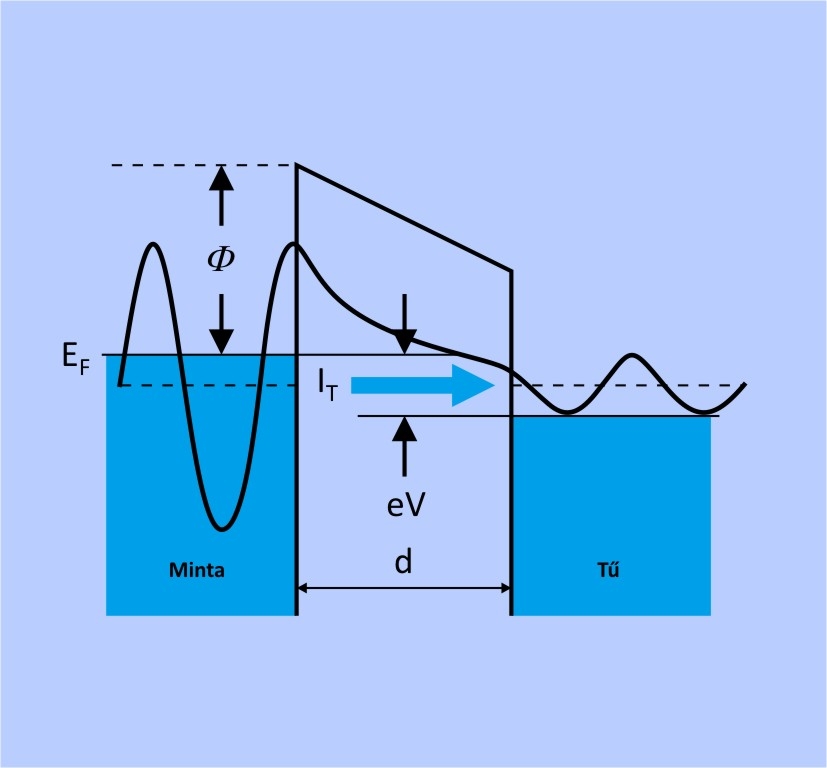
Az alagúthatás
A két fém között folyó alagútáram (It) kiszámítható az alábbi képlet szerint:
ahol a C konstans magában foglalja a φ és az elektronsűrűség értékét (ρ) értéket. Mivel a szondára jellemző kilépési munka és a ρ állandó, ezért az áram csak a szonda-minta távolságtól és a mintára lokálisan jellemző ρ-tól függ. Fontos megjegyezni, hogy It a távolság csökkentésével exponenciálisan növekszik, ez eredményezi a Z irányban elérhető nagyon magas felbontást.

Az STM mérések elvének szemléltetése (az alagútáram mérése)
Az STM vizsgálatok két üzemmódban hajthatók végre. Az egyik módszernél a tűt állandó távolságban tartva mozgatják (constant distance), a másiknál állandó áramot (constant current) tartanak fenn a mozgatás során A topográfiai vizsgálatoknál ez utóbbi a jellemző. Fontos ugyanakkor megjegyezni, hogy az STM műszerek jellegükből adódóan valójában nem az atommagok helyét, hanem az elektronsűrűség eloszlását mutatják.
Az STM technikában a mozgatáshoz léptetőmotoros vagy piezoelektromos egységek használatosak, a szükséges felbontásnak megfelelően. A korábbi rendszerekben három egymásra merőleges egység végezte a tűnek a tér három irányába történő elmozdítását, azonban ma már a korszerű készülékekben cső alakú piezomozgató rendszert alkalmaznak. Ezekben az eszközökben az alábbi ábrán is látható módon a cső hosszirányban négy szegmensre van felosztva, amely szegmensekre illetve a cső közepére feszültséget kapcsolva a feszültséggel arányos elhajlás és nyúlás/összehúzódás érhető el, ami a tű pozícióját elmozdítja az x, y, és z tengelyek mentén.
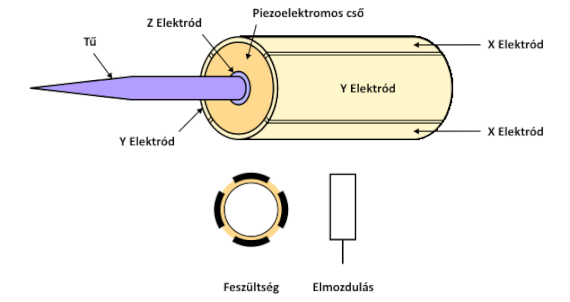
A piezo mozgató működése
A műszerekben használt piezo csövek maximálisan 150 μm-es laterális és 20 μm-es z irányú mozgást tesztnek lehetővé. Ezért egy durvább, a szondát a vizsgált terület közelébe juttató, szélesebb tartományban mozgatható rendszert is szokásos beépíteni az STM készülékekbe.
A mérőcsúcs a STM készülék legkritikusabb része, mivel ennek elektromosan vezetőnek és igen hegyesnek kell lennie (optimálisan egyetlen atomban kell végződnie). Ez elkészíthető Pt/Ir huzal vágásával, vagy Pt, W szál NaOH oldatban történő elektrokémiai hegyezésével is. Rezgésmentes környezet kialakítása nagyon fontos, hiszen a néhány tized nm-es csúcs/minta távolságot a készülék rezgése, a lépések, de még a környezeti hangok is befolyásolhatják.
A mért alagútáram értéke nA-es nagyságú, amelyet A/D átalakítóval feszültség jellé alakítanak, majd – állandó árammal végzett méréseknél – összehasonlítják egy beállított értékkel, ami alapján a mérőcsúcs a szükséges z irányú elmozdulást megteszi. Ezután a szonda a pásztázás irányának és felbontásának megfelelően elmozdul x-y irányban is. A mért áramot (vagy másik üzemmódban a z irányú elmozdulást) a helykoordináták függvényében ábrázolva készül el az STM kép.
Abból következően, hogy a felületen található, szabadon elmozdítható atomokra is hatással van a mérőcsúcs, ezért atomokból képzett építményeket is készíthetünk STM módszerekkel.
Szintén Binnig és munkatársai készítették el az ultramikroszkópiás módszerek egy másik jelentős készülékét, az atomerő mikroszkópot (Atomic Force Microscopy, AFM). Működését vázlatosan az alábbi ábra mutatja be. A felület feltérképezéséhez az AFM tűje egy rugalmas, nagyon finom tartószerkezet (cantilever) alsó felén helyezkedik el. A tű Si-ból, SiO2-ból, vagy Si3N4-ből készülhet mikromegmunkálással. A cantilever hátát lézernyaláb világítja meg, amelyről a nyaláb egy négyes osztatú fotodetektorba tükröződik. Ha a cantilever elhajlik, a lézerfény a detektor más szegmensébe jut, ami a vezérlő/adatgyűjtő elektronika számára jelzi az elhajlás irányát. A tűt a mintafelszínen - az STM-hez hasonlóan - egy finom piezo mechanika mozgatja végig.
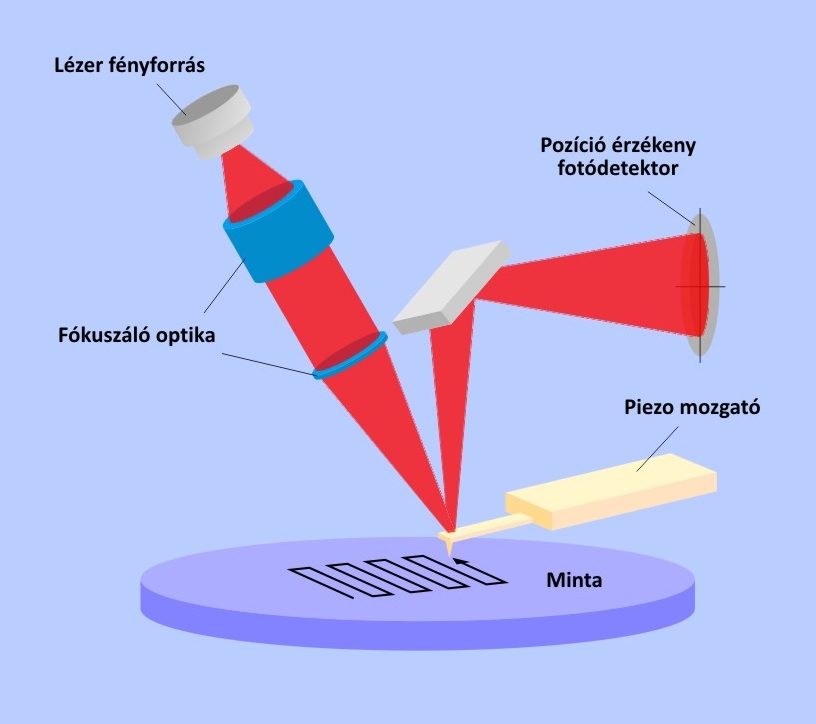
Az atomerő mikroszkóp (AFM) felépítése
Ha a tű néhány nm-el a minta felett – kevéssel a rezonanciafrekvenciája felett – folyamatosan rezeg, az AFM nem-kontakt módban dolgozik. Ilyen távolságban a van der Waals féle vonzóerők hatnak a minta és a tű között, amelyek lényegesen gyengébbek, viszont az oszcilláció frekvenciáját lecsökkentik. Z irányú visszacsatolással érik el, hogy a tű állandó frekvenciával rezegve megfelelő magasságban haladjon a minta felett. A tű/minta távolság adja meg a leképezéshez az információt. Problémát okozhat, ha a felületen nedvesség van, ez ugyanis a felületre húzhatja tűt.

Az AFM mérőcsúcsra ható erők
A másik üzemmód az ún. „kopogtató mód” (tapping), amely során folyamatosan, rezonancia frekvenciájához közeli frekvenciával (kHz nagyságrend), 100 nm-es amplitúdóval oszcillál a tű a vonzó és a taszító erő tartománya között, csak rövid ideig érintve a minta felszínét. Az erő hatására bekövetkező frekvencia csökkenést itt is visszacsatoláson keresztül kompenzálják. Ezzel a módszerrel elkerülhető a minta felületének sérülése, azonban felbontást tekintve a kontakt módban elérhetővel összemérhető minőségű kép készíthető vele.
Az alábbi táblázattal összehasonlíthatók az STM és az AFM módszerek főbb analitikai, használati jellemzői.
| STM | AFM | |
| Felbontás | Atomi léptékű: XY síkon 0,1 - 2 nm, Z irányban 0,005 - 0,1 nm (a letapogató tű görbületi sugara korlátozza) | |
| Topográfiai kép eredete | Elektronsűrűséget mér a Fermi-szinthez közeli betöltött és betöltetlen elektronpályák alapján | Erőt mér - az erő alapja a minta és a tű atomjainak elektrosztatikus kölcsönhatása. Valódi háromdimenziós felületi profilt ad. |
| Vizsgálható felület illetve síktól való eltérés (korrugáció) nagysága | Kis méretű: az XY síkon max. 150 x 150 μm, Z irányban kb. 20 μm | |
| Letapogatás sebesség | SEM-hez viszonyítva kicsi (percek) | |
| Felületmódosítás | Csak fém atomok mozgatása lehetséges a felületen | Lehetséges |
| Minták | Csak vezető minták vizsgálatára alkalmas | Bármilyen minta vizsgálható |
| Környezet | Nagyvákuum, max. 400 K | Légköri nyomás, folyadékok, vákuum alkalmazása egyaránt lehetséges |
| Mintaelőkészítés |
|
|
| Nehézségek |
|
|
Az SPM technikák létrejöttével olyan újfajta vizsgálati módszerek keletkeztek, amelyek nagymértékű fejlődést tettek lehetővé az anyagtudományok számos területén, például a félvezetők vizsgálata vagy az adszorpciós folyamatok tanulmányozása területén. A biotechnológiában képek készültek a DNS-ről, membránokról, enzimfehérjékről. A nanotechnológiában is igen értékes vizsgálati eljárások ezek a módszerek. Az AFM tű módosításával számos további vizsgálat is elvégezhető, így a tűhöz kötött funkciós csoportokkal feltérképezhetők a minta megfelelő csoportjai a köztük kialakuló erők alapján, vagyis a vizsgálatok kémiailag szelektívvé is tehetők.
Milyen SEM gerjesztési térfogatokat tud elkülöníteni?
Hasonlítsa össze az SEM és az SPM technikával történő képalkotást!
Hogyan működik az STM mozgatórendszere?
Jellemezze és hasonlítsa össze az AFM és az STM felületanalitikai képességeit!
Milyen AFM üzemmódokat ismer? Hasonlítsa ezek jellemzőit össze!
