Az ionforrásból származó gyorsított ionokkal bombázva a mintát, azok a) a minta felületéről visszaverődnek vagy b) a mintából másodlagos ionokat löknek ki. A visszaverődő/kilépő ionok detektálásán keresztül a minta felületi összetétele meghatározható.
Egy ionforrásból kilépő pozitív töltésű, könnyű ionokkal bombázva a minta felületet az ionok a minta alkotóival történő ütközések során – mechanikai törvények alapján az ütközés szögétől és a mintát alkotó atomok tömegétől függően – energiát vesztenek és visszaszóródnak az ionforrás irányába. Nehéz atomokkal ütközve nagy energiájú, míg könnyű atomokkal ütközve kis energiájú ionok szóródnak vissza. Állandó beesési szög mellett detektálva a visszaszórt ionok energiáját azonosíthatók a felületen lévő atomok és következtetni lehet a köztük lévő kötésekre. A besugárzó ionnyaláb energiája alapján elkülönítjük 100eV – 10 keV között az alacsony energiájú ionszórásos spektroszkópiát (low-energy ion scattering spectroscopy, LEIS), 100-200 keV között a közepes energiájú ionszórásos spektroszkópiát (medium-energy ion scattering, MEIS) és 1-3 MeV között a nagy energiájú ionszórásos spektroszkópiát (high energy ion scattering, HEIS) vagy más néven Rutherford-féle visszaszórásos spektroszkópiát (Rutherford backscattering spectroscopy, RBS). Összefoglalóan ezeket a módszereket ionszórásos spektroszkópiai módszereknek nevezik (ion scattering spectroscopy, ISS).
Ezen módszerek első leírása 50 évvel ezelőtt történt, így az RBS módszer alkalmazásáról elsőként S. Rubin, T.O. Passell, E. Bailey írt 1957-ben.
Az ionszórásos spektroszkópiában nemesgáz ionok (He+, Ne+, Ar+) szolgáltatják a besugárzó ionnyalábot. Az ionforrásokról a 3.1.2. fejeztben bővebben írtunk. Az ionnyalábot a mintára fókuszálják, ahol azok az ütközések során energiát veszítenek, majd visszaszóródnak. A visszaszóródó ionokat detektálva energia spektrum készül, ahol az ionok energiájának függvényében ábrázolják az adott ion intenzitását. A detektáláshoz elektrosztatikus szektort vagy repülési idő analizátort használnak (lásd a 3.4.1. fejezetben).
Két részecske közötti egyszeri ütközést során az alábbi energiaviszonyok alakulnak ki:
E – visszaszórt ion energiája, E0 – ion kiindulási energiája, M1 – ion tömeg, M2 – minta atomjának tömege, θ – beesési szög
A képlet alapján megállapítható, hogy nem lineáris az összefüggés az M2 és az E/E0 között, vagyis a nehezebb atomok esetén kisebb lesz az energiaváltozás, így az energiaspektrumban a csúcsok átfedhetnek.
A mintába bejutó ionok rugalmatlan ütközések során a minta néhány atomsornyi (<10 nm) rétegéből visszaverődve többszörös ütközés után, a felszínről visszaszóródó ionoknál kisebb energiával jelennek meg a detektorban. Az ennél mélyebbre jutó ionok a sok ütközés során már töltésüket vesztik, ezért nem detektálódnak. A minta kristályszerkezete meghatározható az intenzitás szögfüggésének vizsgálatával.

Az RBS technika működési elve
Az RBS technikában nagy energiájú (akár néhány MeV) He+, He2+ ionokkal bombázzák a felszínt. A visszaszóródó ionokat Si alapú részecske detektorokkal számlálják. A nagy energiájú sugárzás eredményeként a minta 1000 nm-es mélységéig is nyerhető információ, amely az atomtömegeken keresztül az összetételre és annak a felszín alatti eloszlására vonatkozik.
A LEIS nagyon felület érzékeny módszer, mivel az ionok visszaszóródása a felület legfelső rétegéből történik, ezért különösen értékes módszer pl. ötvözetek, katalizátor anyagok, üzemanyag cellák, implantátumok vizsgálatánál. Kimutatási határa nehéz elemeknél ppm nagyságrendű, míg könnyű elemekre néhány %. Jelentős előnye más vizsgálati módszerekkel szemben, hogy szerkezeti információ is nyerhető vele pl. félvezetők, fémek, oxidok vizsgálata során. A mennyiségi meghatározást megnehezíti, hogy rugalmatlan ütközések miatt az ionok egy része semlegesítődik, így nem lesz detektálható.
Az RBS-sel abszolút mennyiségi információk nyerhetők néhány % pontossággal. Mélységi profil készítésére alkalmas, azonban a nagy energiájú részecskék miatt a felületi réteg elemzése nem lehetséges, sőt gyakran roncsolja is azt (pl. szigetelő anyagok pl. polimerek, alkálifém-halogenidek és -oxidok esetében).
Az előző felületvizsgáló módszerektől eltérő elvekre épül, és a mintára nézve destruktívabb a szekunder-ion tömegspektrometria (secondary ion mass spectrometry, SIMS), melynek alapja, hogy egy primer ionforrásból származó, nagy kinetikus energiájú ionok a minta felületén rugalmasan vagy rugalmatlanul ütköznek (a rugalmas ütközés energiaátadás nélküli, a rugalmatlan azzal együtt járó ütközést jelent). Az eltalált alkotók elmozdulnak és környezetükben további atomokat is elmozdítanak, melyek egy része a minta felületből kilép. A kilépő anyagnak csupán rendkívül kis hányada (< 1%) ionizálódik az ütközések során, de ezen hányad tömegspektrometriás detektálása lehetséges. Mivel csak legfeljebb a felszínhez közeli, mintegy három atomnyi rétegből történhet kilépés, a SIMS módszert kvalitatív felületelemző módszernek tekinthetjük. Az ionhozamot a minta anyagi minősége és kémiai környezete is befolyásolja, ezért a SIMS nem használatos mennyiségi elemzésre.

A SIMS működésének vázlata
A SIMS az 1960-as évektől fejlődött felületanalitikai módszerré, kifejlesztése Liebel és Herzog, illetve Castaing nevéhez köthető.
A SIMS készülék fontos alapegysége a primer ionokat előállító ionforrás (lásd 3.1.2. fejezet). A számos alkalmazott pozitív ion közül kiemelhetők az elektronütköztetéssel vagy plazma segítségével előállított ionok, pl. a nemesgázionok (Xe+, Ar+) vagy O2+ valamint a folyékony fémből előállított ionok pl. Ga+, In+. A használt primer ionok energiája 0,5-50 keV tartományba esik. A gázionok alkalmazásának előnye, hogy nagyobb sűrűségű ionnyalábot adnak, azonban a nyaláb által besugárzott felület is relatíve nagy. Ezzel szemben a fémionok nyalábba jobban fókuszálhatók, így akár 100 nm-es átmérőjű foltban is végezhetők mérések. A nemesgáz ionok előnye, hogy nem lépnek számottevő kémiai reakcióba a minta atomjaival.
A minta ultranagy vákuum térben helyezkedik el (<10-8 Pa), amelyben a gázadszorpció elhanyagolható.
A keletkezett szekunder ionokat az energiaszűrőbe fókuszálják, amely eltávolítja a szóródott primer ionokat és kiválasztja a tömeganalizátor által befogadható ionokat. Tömeganalizátorként gyakran kvadrupol vagy repülési idő (ToF) tömegspektrométereket alkalmaznak (lásd 3.4.1 fejezet). Az analizátorból a detektorba jutnak az ionok, amelyet végül a jelfeldolgozó egység követ. ToF analizátor alkalmazása esetén az ionnyalábot időben szakaszolva kell a mintára juttatni, mivel az analizátor is szakaszosan képes a szekunder ionokat fogadni.
A SIMS alkalmazása során három üzemmódot különböztetünk meg. Statikus üzemmódban a minta felületének elhanyagolható roncsolása mellett történik a vizsgálat. Ehhez kis dózissűrűségű (1012-1014 ion/cm2) primer ionnyalábbal a felület kb. 1%-át távolítják el és elemzik. Ez az eljárás kíméletessége miatt akár szerves anyagok vizsgálatát is lehetővé teszi. Dinamikus üzemmódban már lényegesen nagyobb ionsűrűséggel (1017 ion/cm2) a felület eltávolítása a cél, hogy egy (destruktív) mélységi profil is készülhessen a mintáról. Térképezés módban a felületen jól fókuszált ionsugár pozíciójának változtatásával pontról-pontra elkészül a tömegspektrum. Ezzel a minta laterális inhomogenitásának képszerű megjelenítése történik meg, akár 20 nm-es felbontás mellett.
Az MS készülékbe jutó anionok és kationok külön-külön detektálhatók. A korábban említtek szerint a kilökődő részecskéknek 99%-a azonban nem ionos (atomok, molekulák, klaszterek stb.), az elemzéshez ezeket ún. utóionizálással lehet MS által vizsgálhatóvá alakítani. Erre alkalmas a plazma, elektronsugár, vagy lézer hatására történő ionizáció.
A szekunder-ion tömegspektrometria a felületet alkotó izotópok minőségi és mennyiségi azonosítást teszi lehetővé a periódusos rendszerben a hidrogéntől uránig terjedő tartományba eső elemekre vonatkozóan. Az érzékenysége a rendszámtól nagyon függő, általában kb. 1012 – 1016 atom/cm3. Mélységi koncentráció profilt is lehetséges készíteni vele, akár 5-10 nm-es felbontással is. Az ionnyaláb átmérője a gázionok esetében jellemzően 50 μm és néhány mm közé esik, míg a jól fókuszált fémionokkal 100 nm alatti is lehet.
A PIXE (particle/proton induced X-ray emission, PIXE) módszer elve hasonló az ionszórásos spektroszkópiánál bemutatottakhoz: töltéssel rendelkező részecskékkel, ez esetben leggyakrabban protonokkal, ritkán He+ ionokkal bombázzák a minta felszínét. Az ionnyaláb a minta felületével ütközve a minta komponenseit gerjeszti, amelyek röntgenemisszóval relaxálnak. A proton a minta egy belső héjáról elektront lök ki, a helyén lyuk marad, ion képződik. A lyuk betöltődhet egy külső elektron belépésével, miközben az energiakülönbség röntgensugárzás kibocsátásával vagy egy külsőhéjon lévő elektron által felvéve elektronemisszióval jár (Auger folyamat).
A vizsgálat során a protonnyaláb egy része visszaszóródhat más része átjuthat a mintán, amelyek detektálásán keresztül szintén a mintára jellemző analitikai információhoz lehet jutni. A gyakorlati alkalmazások azonban nagyrészt a röntgensugárzás detektálására, röntgenspektroszkópiára épülnek (lásd pl. 6.5 fejezet).
A PIXE módszert először 1970-ben Johansson és munkatársai írták le.
A PIXE számára laboratóriumi körülmények között a protonnyalábot kis energiájú részecskegyorsítóban, Van de Graaff generátorral állítják elő, 2-3 MeV energiára gyorsítva a protonokat. Ezután a protonnyaláb megfelelő kollimálása mellett besugározzák a minta felületét. A kollimátor nagyvákuumot igényel, azonban a minta légköri nyomáson vizsgálható; a kettőt egymástól egy polimer ablak választja el egymástól általában. A mintában a gerjesztés hatására 0,05-110 keV energiájú, a mintakomponensekre jellemző K és L sorozatú röntgensugárzás alakul ki. A sugárzás energiája és a kibocsátó atom minősége között egyértelmű összefüggés áll fent, emiatt a röntgenspektrumból a mintakomponensek kvantitatív és kvalitatív meghatározására egyaránt lehetőség van. A röntgenspektrumot energiadiszperzív Li adalékolt Si detektoron rögzítik. Ez a detektortípus a 2-20 keV energiájú röntgenfotonok esetében működik megfelelő érzékenységgel. Mivel ebben a tartományban találhatók a 6<Z<47 elemek K-vonalai, valamint a Z<92 elemek L-vonalai, a bór és az urán közé eső elemekre PIXE analízis végezhető.
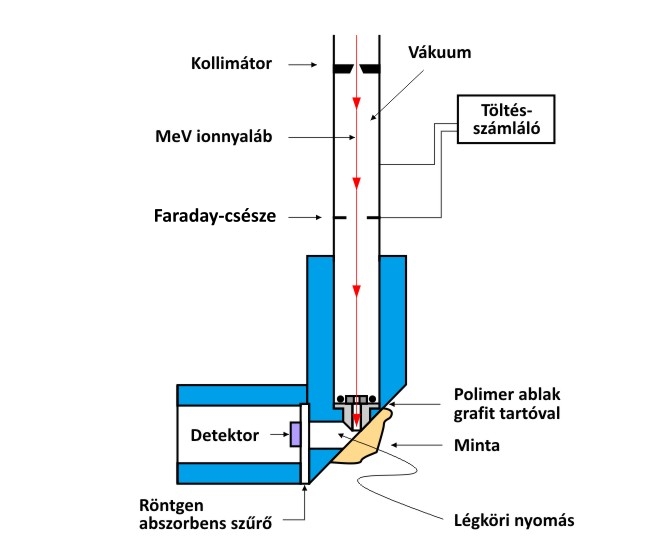
A PIXE készülék felépítése
A spektrum felbontását a Mn Kα vonalának félértékszélességeként definiálva 130 eV értéket kapunk, amely alapján az energiaspektrumban vizsgálható rendszámtartományban valamennyi elem csúcsa elválik egymástól. Azonban háttérsugárzást adnak és a spektrumban az alapvonalat eltolják a gerjesztő részecskék valamint az általuk kilökött elektronok fékezési sugárzása.
A röntgensugárzás keltésének hatásfoka a teljes vizsgált tartományban magas, emiatt a PIXE eljárás nagy érzékenységű. Az EDS-sel összehasonlítva jobb jel/zaj viszonyt, így nagyobb érzékenység jellemzi a PIXE módszert. A P-Th között a módszer relatív érzékenysége akár 0,1 μg/g (ppm) is lehet, a kimutatható legkisebb anyagmennyiség 10-9–10-15 g, a nyaláb mérettől, minta vastagságától, mátrixától függően. A nagyon nagy érzékenység miatt szokásos szűrőket elhelyezni a detektor előtt, amely a nagy intenzitású komponensek jelét csökkenti, ezáltal a kisebb intenzitásúak nyomnyi mennyiségei is detektálhatókká vállnak. A nyalábot kis területre fókuszálva lehetséges a terület anyagösszetételének vizsgálata, amely a módszerre jellemző alacsony kimutatási határ miatt nagyon népszerűvé tette a mikro-PIXE eljárást.
Nagyon kis mintamennyiséget igényel. Mintaelőkészítésre nincs szükség, hiszen a mintát légköri nyomáson lehet vizsgálni, így a vizsgálandó tárgyból nem szükséges mintát venni. Mivel a levegő összetevőiben könnyen elnyelődik a kis energiájú röntgensugárzás, a minta és detektor közti teret gyakran héliummal töltik fel. A módszer roncsolásmentes, ezért nagyon fontos alkalmazása a festmények, régészeti leletek vizsgálata.
Hasonlítsa össze az ISS és az RBS módszert! Emelje ki a két módszerrel nyerhető információk közti különbségeket!
Mi a különbség a statikus és a dinamikus SIMS módszerek között?
Milyen ionnyalábot alkalmazó módszerekkel vizsgálható a mintán belüli mélységi koncentráció eloszlás?
Milyen módszert választana polisztirol felületén adszorbeált fehérjék vizsgálatához? Indokolja!
Milyen ionnyalábot alkalmaznak az ISS ill. a SIMS módszerek?
