A minta felület közeli rétegeinek elemzésére használt módszerek közül a fotonnyalábot alkalmazók (photoelectron vagy photoemission spectroscopy, PES) a fény hullámhossza alapján két nagyobb csoportra bonthatók, úgy mint ultraibolya (ultra-violet photoelectron spectroscopy, UPS) és röntgen (X-ray photoelectron spectroscopy, XPS) sugárzást alkalmazó eljárásokra, valamint az Auger-effektuson alapuló Auger elektron spektroszkópiára (AES). A foton hullámhosszától függetlenül a minta gerjesztésével elektronokat löknek ki, melyek kinetikus energiáján keresztül azonosíthatók a mintakomponensek. Az alábbi tárgyalás elsősorban az XPS és AES módszerre koncentrál.
Szilárd-, folyadék- és gázhalmazállapotú mintákban egyaránt megfigyelhető a fotoelektromos hatás, amelyben egy fotonnyaláb kellően nagy energiájának hatására a mintából elektronok lökődnek ki. Az emittált elektronok energiája jellemző a mintát alkotó részecskékre illetve a besugárzó energiaforrásra. A folyamat során a foton megsemmisül és ionok keletkeznek.
M + foton → M+ + e-
A molekulában eredetileg gyengébben és erősebben kötött elektronok kinetikus energiája a kilökődés után is különböző lesz, ezért az emittált elektronok energiáját mérve és ennek függvényében a számukat vagy az intenzitásukat ábrázolva kapjuk az fotoelektron-spektrumot.
A kilökött elektronok mozgási energiája függ az eredeti elektronpályán elfoglalt helyétől, továbbá a besugárzó monokromatikus fény energiájától és intenzitásától. A gyengébben kötött vegyértékelektronok leszakításához az UV fény fotonjainak energiája elegendő, azonban a belső héjakról elektronokat csak a nagyobb energiájú röntgenfotonokkal lehet kilökni, ennek megfelelően az eljárásokat a fényforrás hullámhossza szerint két csoportra bontják: UPS és XPS.
Az XPS alkalmazásakor megfigyelhető az ún. Auger folyamat is, vagyis a gerjesztés hatására a belső pályákról kilépő elektronok megüresedett helyére egy külső elektron pályáról elektron léphet be. A folyamat energia felszabadulásával jár, amely energia elegendő lehet arra, hogy egy további, külső héjon lévő elektron, ún. Auger elektron emittálódhasson az atomból. Ezen elektronok detektálásán alapul az Auger elektron spektroszkópia (AES) módszere. Auger-folyamat lejátszódhat elektrongerjesztés hatására is. Ha a relaxáció végső lépéseként Auger-elektron helyett röntgen foton emittálódik, röntgen fluoreszcenciáról beszélünk, amelyet a 6.5 fejezetben tárgyalunk. A két kompetitív folyamat közül az Auger az alacsonyabb, míg a fluoreszcencia a magasabb rendszámú elemeknél domináns.

A fotoelektromos hatás által okozott változások
A fotoelektromos hatást Hertz fedezte fel (1887), és Einstein is vizsgálta (1905). Analitikai módszerré Kai Siegbahn fejlesztette a PES-t (első XPS mérés; 1954), amiért 1981-ben Nobel-díjat kapott.
A PES spektroszkópiában használatos eszközök általános felépítését az alábbi ábra mutatja.
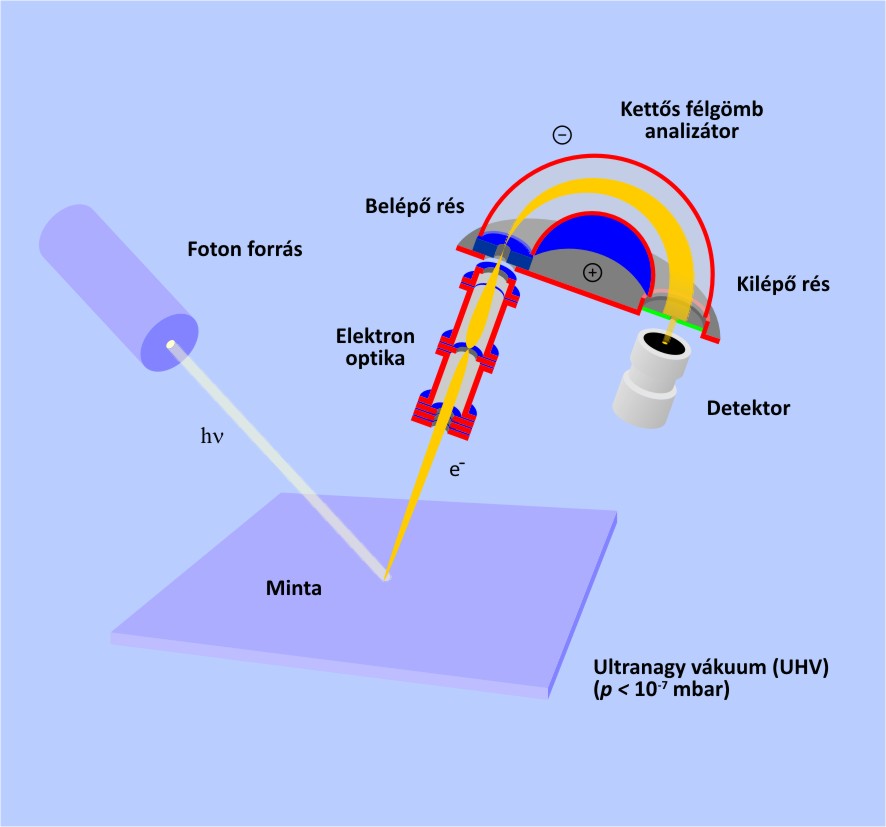
Egy fotoelektron spektrométer vázlatos felépítése
Az elektronspektroszkópiában használatos készülékben fontos szerepe van a fényforrásnak. UPS esetén ez egy He tartalmú kisülési cső, amelynek általában az 58,4 nm-es hullámhosszú vonalát alkalmazzák a minta gerjesztésére. Mivel a sugárzás energiája kicsi (21,22 eV), ezért UPS-sel elsősorban gázhalmazállapotú minták, továbbá felületen adszorbeált molekulák és szilárd minták legfelső, pár nm-es rétegének vizsgálatára van lehetőség. A gerjesztő sugárforrást és a mintát alacsony nyomású (~10-8 mbar) térben helyezik el, hogy az UV fotonok és a kilökött elektronok ne veszítsenek energiát az ütközésekkel.
A fotonsugár hatására a mintából minden irányban kilépnek elektronok, melyek egy része az analizátorba jut. Itt történik meg az elektronok energia szerinti szétválasztása, mivel az alkalmazott elektromos vagy mágneses tér hatására az eltérő energiájú elektronok különböző sugarú pályán haladnak és érik el az analizátor végén lévő mozgatható rést. A legtöbb kereskedelmi forgalomban kapható készülékben ún. félgömb analizátorokat találunk, amelyek lényegében elektrosztatikus szektorok.
Az elektronspektrum függőleges tengelyére egy adott kinetikus energiájú elektronok időegység alatti száma, míg az ionizációs energia (vagy a fotoelektron energia) a vízszintes tengelyére kerül. Érdemes megemlíteni, hogy egy korszerű berendezés detektorába 1 másodperc alatt 1–106 elektron jut, ami 10-19 – 10-13 A árammal ekvivalens. Az ilyen kis áram mérése helyett egy elektronsokszorozót is beépítenek a detektor konstrukcióba. A spektrumfelvétel sebességének gyorsításához a modern készülékek akár 3-5 detektort is tartalmaznak, melyek jelét szoftveresen összegzik.
Az XPS fotonnyaláb forrása a magnézium vagy az alumínium Kα sugárzása (MgKα= 1253,6 eV, AlKα =1486,5 eV). Részletes leírását lásd a 3.2.2. fejezetben. A sugárzások sávszélessége viszonylag nagy (~1 eV), ezt kvarckristály ráccsal csökkentik 0,2 eV-ra. Azonban még ez is egy viszonylag széles tartomány, ennek következtében az XPS spektrumban a finomszerkezet nem jelenik meg olyan részletességgel, mint az UPS spektrumban, ahol a vonalszélesség csak 0,01 eV. A XPS nagy előnye azonban a sugárzás nagy gerjesztő energiájában rejlik: képes a minta belső, atomtörzsekhez tartozó elektronjainak emittálását is előidézni, amelyek energiája nagyrészt független a kémiai környezettől. Ezek alapján az XPS egy kiváló módszer szilárd halmazállapotú minták felületi vizsgálatára.
Az egyes molekulák eltérő elektronszerkezete miatt ezek a módszerek az ionizációs energiákon keresztül az egyes elektronpályákra jellemző adatokat nyújtanak, ezáltal rendkívül szelektív kvalitatív azonosítási lehetőséget biztosítanak. Mindemellett – különösen az XPS módszerrel – kvantitatív vizsgálatok elvégzése is lehetséges.
XPS-sel az elemezések – bár a gerjesztő sugárzás akár néhány μm mélységbe is behatol – a minta felszíntől mért kb. 10 nm-es vastagságáig végezhetők el, ugyanis a minta ennél mélyebb rétegeiből emittálódó elektronok beleütköznek a felettük lévő rétegek atomjaiba és szétszóródnak, ill. mozgási energiájukból veszítnek. Ezért nevezhetjük az XPS-t felület érzékeny módszernek. Az információs mélység tovább csökkenthető, ha az alaphelyzetben a felszínhez képest merőlegesen elhelyezkedő detektort kisebb szögben (45-75 fok) helyezik el, ekkor ugyanis a minta mélyebb rétegeiből emittált elektronok könnyebben ütköznek a minta atomjaiba, megnő az ütközések száma, vagyis lecsökken a vizsgálható réteg vastagsága a felszín közeli ~ 2 nm-es régióra. Ez az eljárás (angle resolved XPS) különösen felületi folyamatok (pl. adszorpció) vizsgálatainál előnyös. Mélyebben elhelyezkedő rétegek vizsgálatához ionmaratással (nagy energiájú Ar+ ionokkal bombázva a felszínt) eltávolíthatók a felszín közeli komponensek, majd az így letisztított felület válik vizsgálhatóvá. Az XPS vizsgálatok laterális felbontása ugyanakkor nem kiemelkedően jó, a legjobb esetben is a felszín min. 20-50 µm2-os területét vizsgálhatjuk.
A minőségi elemzéshez először többnyire egy áttekintő felvétel készül a mintáról 0 és 1250 eV kötési energia tartományban. Az áttekintő spektrumhoz a legnagyobb energiájú gerjesztő sugárzást alkalmazva a mintában jelenlévő összes elem és azok intenzitása azonosítható lesz, mivel a kis rendszámúaknál egy, a nagyobbaknál több belső héjon lévő elektron is kilökődik. Az elektronok ionizációs energiáinak kvantáltsága miatt a kapott spektrumvonalak jól azonosíthatók, ehhez táblázatban összefoglalva elérhetők az egyes elemekre jellemző értékek. Referenciának a C 1s csúcsot szokás tekinteni, melynek kötési energiája 285,00 eV. A legalább 0,1%-ban jelenlévő komponensek spektrumvonalai már detektálhatók. Az összetett spektrumok kiértékelésékor minél több spektrumcsúcs figyelembevételével lehet a legpontosabban azonosítani az egyes elemeket.
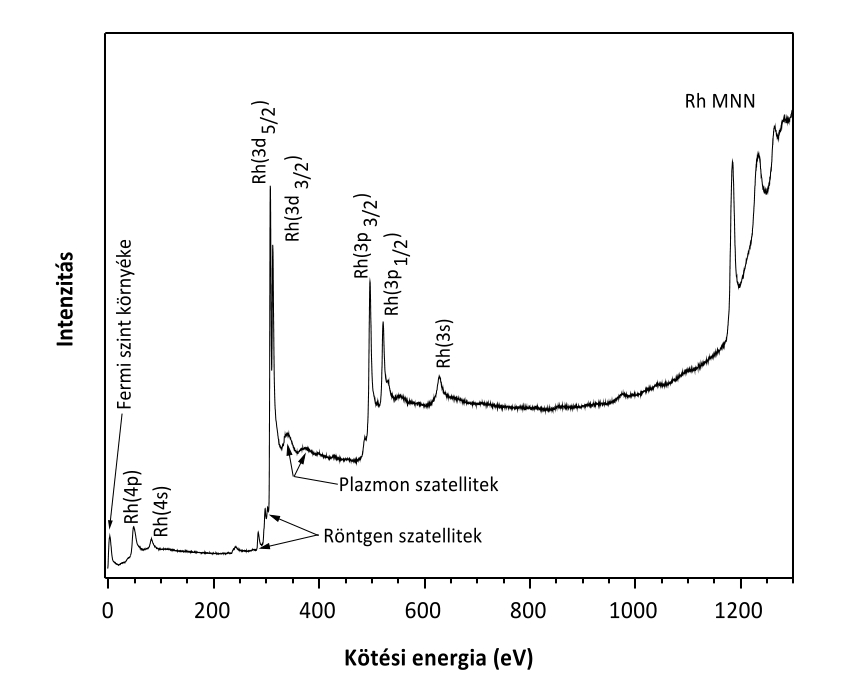
Rh(111) egykristály felületről készített áttekintő XPS spektrum
A nulla kötési energia megfelel a Fermi-szintnek, fémes vezetők esetén a spektrum innen indul. A nagyobb kötési energiák felé haladva a maghoz egyre közelebbi elektron pályáktól származó elektronok jeleit találjuk. A bemutatott spektrumban, a nagy kötési energiájú végén – az ábrán Rh MNN-nel jelölve – az ún. Auger elektronoktól származó csúcsokat látunk. A spektrumban az Auger átmenetek és a fotoelektronok egyértelmű elkülönítése úgy lehetséges, hogy mind Mg és Al gerjesztéssel is felvesszük a spektrumot. Mivel az Auger elektronok energiája független a gerjesztő sugárzástól, spektrumcsúcsaik mindkét típusú gerjesztésnél ugyanott (ugyanakkora energiánál) jelentkeznek a spektrumban. Ezzel szemben fotonok által kilökött elektronok (fotoelektronok) energiája 233 eV-nyi eltolódást fog mutatni a két esetben (ekkora a MgKα és AlKα sugárzás közötti energiakülönbség).
A bemutatott Rh XPS spektrumon jellegzetes az alapvonal megemelkedése is egy-egy csúcs mögött. Visszatekintve az elektronok származására, látható, hogy csak a felszínről kilépő elektronok juthatnak energiaveszteség nélkül a detektorra. A mélyebb rétegekből származó elektronok esetén azonban már a mélységgel növekvő számú ütközést is fel kell tételeznünk, amely az elektronok kinetikus energiájának folytonos csökkenését okozza. A felszínről kilépő elektronok okozzák tehát az éles spektrumvonalakat a lépcsők élén - mégpedig ezek az elektronok pályáinak sorrendéjében jelennek meg - , míg az energiaveszteséget szenvedett elektronokból adódik össze a háttér, növelik az alapvonalat. Az ábrán megfigyelhetők még a nem monokromatikus röntgensugárzás által létrehozott röntgen szatellitek, továbbá a mintából kilépő elektronok és a minta atomok kölcsönhatásaként létrejött plazmon szatellitek is.
Az XPS spektrum jellegzetessége a vonalak felhasadása, vagyis vonalpárok, dublettek jelennek meg. Ez adja az XPS technika egyik legfőbb előnyét, mivel azonosíthatók az egyes elemek oxidációs állapotai is, sőt a csúcs alatti területből pedig ezek mennyiségi viszonyai is.
A spektrumvonalak felhasadása megfigyelhető a következő ábrán, amely egy analitikai tisztaságú MoO3 felületéről készített Mo 3d spektrum is. Ennek oka, hogy a bór atomtól kezdődően („l” mellékkvantumszám > 0 ) dublettet kapunk az e- spin és pályamomentumok csatolása miatt. A dublett csúcsok a j= l ± s momentummal bírnak, a d pálya (l = 2) esetén tehát j = 5/2 és 3/2. A két csúcs alatti területnek (intenzitásának) aránya megegyezik az egyes csúcsok arányával (a lehetséges állapotok nincsenek elkülönítve az „m” mágneses kvantumszám szerint). Adott j esetén a m= 2j + 1 értéket vehet fel, tehát a d pályát tekintve [2 × (5 / 2) + 1] / [ 2 × (3 / 2) + 1], vagyis 3:2 arány adódik. A p és f dublettek intenzitás aránya hasonló módon számítható.
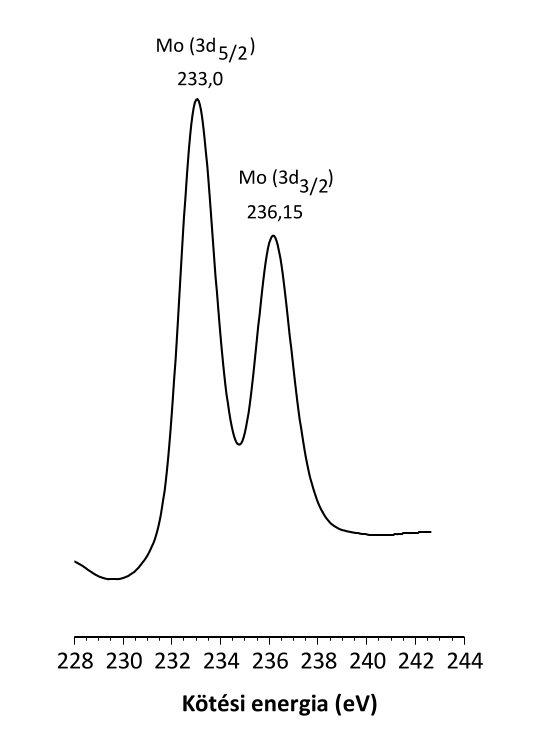
A Mo 3d XPS spektrumvonalai (tiszta MoO3 kristályon felvett spektrum)
Az XPS technikában a kémiai eltolódás, vagyis a spektrumvonalak eltolódásának vizsgálatán keresztül rendkívül hasznos információkhoz lehet jutni a mintakomponensek kémiai környezetének, vegyértékállapotának változásáról. A kémiai eltolódás oka az atomtörzsek körüli parciális töltések okozta energiaváltozás. Ha például egy semleges atomból egy elektront eltávolítunk, a megmaradó elektronokra eső vonzóerő, ezáltal a kötési energia is növekszik. Ennek mértéke többnyire 0,1-10 eV közé esik, pozitív oxidációs állapotokhoz pozitív irányú eltolódást mérhetünk, míg negatívnál negatívat. A pontos eltolódási értéket mérve meghatározhatók a például vizsgált atom kémiai kötései, de ehhez nagy felbontású, szűk energiatartományban felvett spektrum szükséges. Az ilyen spektrumban kismértékű eltolódások sokszor összetett csúcsokként jelentkeznek, de a csúcsok számítógépes felbontásával (dekonvolúció) meghatározható az eltolódás értéke.
Egy XPS spektrum csúcsának dekonvolúciójára mutat példát az alábbi ábra. Mo 3d spektrumot vizsgálva a dekonvolúció segítségével megállapítható, hogy az egyes oxidációs állapotú komponensek milyen arányban vannak jelen a mintában.

Dekonvolvált Mo 3d XPS spektrum (Mo2C/SiO2 katalizátor )
Az összetétel ezen a módon történő, elfogadható pontosságú mennyiségi meghatározásának feltétele, hogy az adott komponensek legalább 5% koncentrációban és egyenletes eloszlásban legyenek jelen a vizsgált rétegben. Ekkor – belső standard használatával – kb. 5%-os relatív hibával megállapítható egy komponens mennyisége az adott energiájú fotoelektron csúcsok intenzitásából (I). I ~ nφS, ahol n – az atomsűrűség (atom szám /cm3), φ – gerjesztő röntgensugárzás fluxusa (fotonok száma/ cm2 s), S – érzékenységi faktor, amely a mintára és a műszerre jellemző paramétereket foglal magában.
Analitikai szempontból az AES és az XPS módszerek egymás kiegészítői, ezért a gyártók gyakran egy készülékbe integrálják ezeket a vizsgálati lehetőségeket. Az AES előnyösebb a kis rendszámú elemek mérésénél, kevésbé érzékeny a mátrixra és jobb térbeli felbontás érhető el vele (elektrongerjesztés esetén, aminek az az oka, az elektronnyaláb jobban fókuszálható, mint a röntgen-fotonnyaláb). A jól lefókuszált nyalábot mozgatva a felület anyagösszetétele feltérképezhető, ezen alapul a pásztázó Auger-mikroanalízis (Scanning Auger Microprobe, SAM) módszere. Az AES-t jellemzően nem használják a szerkezet és az oxidációs állapot vizsgálatára, és inkább félkvantitatív alkalmazások jellemzőek. Az Auger elektron spektrumokat a minta kis (pl. 5-500 μm átmérőjű) területéről veszik fel. Noha a gerjesztő részecskék mélyen behatolnak a mintába, onnan csak 4-5 atomi rétegből (0,3 – 2 nm) kilépő elektronok jutnak el az analizátorra. Így a kapott információ a legkülső felszínre vonatkoztatható. Nagyobb mélységű elemzéshez, akár mélységi koncentrációprofil készítésére a felületi rétegek pl. argon ionmaratással történő folyamatos eltávolítása után van lehetőség.
Az UPS spektrumban az ionizáló sugárzás hatásaként – az elektron emittálása mellett – a minta rezgési és forgási energiaállapotai is gerjesztődnek, amely az elektronspektrumban finomszerkezetként jelenik meg. A kisebb energiához rendelhető csúcs a rezgési energiának, míg a nagyobb az ionizációs energiának felel meg.
A PES módszerek széleskörű ipari alkalmazása annak köszönhető, hogy az analitikai információt kis területről gyűjtik, ezért mikroanalitikában és felületi kémiai/fizikai folyamatok vizsgálatában nagyon előnyösen használhatók. A drága és bonyolult nagyvákuum technika miatt azonban nem mindig versenyképesek a hagyományos anyagvizsgálati módszerekkel. További fontos szempont, hogy a vizsgálandó minta nem lehet porszerű, nem degradálódhat UV/röntgensugárzás hatására és vákuum állónak is kell lennie.
Az elektronikai iparban a nagyon széleskörű alkalmazhatóság magában foglalja a mikroelektronikai alkatrészek vizsgálatát, a szenzorkészítés technológiai lépéseinek ellenőrzését, vagy az optikai fényvezetők módosításainak vizsgálatát is. Vegyiparban egyebek között heterogén katalizátorok vizsgálatára, műanyagipariban polimerek fejlesztésre, fóliák felületének vizsgálatára alkalmazzák.
Mivel roncsolás mentes vizsgálatok végezhetők vele, biológiai mintákat is gyakran elemeznek XPS módszerrel: gyógyszer kioldódás vizsgálatok, implantátumok felületeinek kialakítása és kopásállóságának ellenőrzése, fogászati anyagok korróziós tulajdonságainak felderítése.
Milyen főbb jellemzők különböztetik meg az UPS és az XPS technikákat?
Milyen fotonforrásokat használ az XPS?
Hogyan különíthetők el az Auger elektronok egy fotoelektron-spektrumban?
Milyen jellegzetességei vannak egy XPS spektrumnak?
Mi okozza a PES módszerek felületérzékenységét?